四探针电阻率测试仪测量结果的不确定度评定
电阻率是半导体材料的核心参数,四探针电阻率测试仪是其主要测量器具,测量结果的不确定度评定对提升数据可靠性至关重要。下文,依据 JJG 508-2004《四探针电阻率测试仪》,以硅单晶电阻率标准样片为标准器,分析测试仪测量结果的影响因素,完成标准不确定度、合成标准不确定度及扩展不确定度的计算与评定,为该仪器的计量检定提供参考。
一、四探针法测量原理
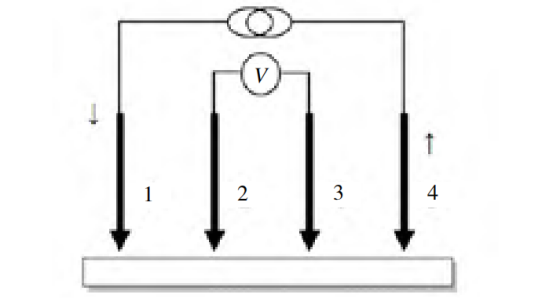
四探针法原理图
直线型四探针测试法是半导体材料电阻率测量的主流方法,可有效减少接触电阻、边缘效应对测量结果的干扰。该方法将四根探针等距竖直排列,施加适度压力使探针与硅片表面形成欧姆接触,外侧两根探针接入恒流电源,中间两根探针通过高精度电压表检测电压差,结合理论公式计算电阻率。
实际测量中需考虑样片厚度与边界效应,引入直径和厚度修正因子;当样片直径远大于探针间距时,电阻率可简化计算,公式为ρ=2πSIV,其中S为探针间距,I为恒定电流,V为中间探针的电压差,确定这三个参数即可得出电阻率值。
二、测量条件与方法

Xfilm埃利四探针测试仪
试验评定以标准值 1 Ω・cm 的硅单晶电阻率标准样片为被测对象,检定环境遵循 JJG 508-2004 要求,控制在 (23±2)℃,并以 23℃为基准进行结果修正。
测量方法严格按照规程执行:将四探针电阻率测试仪电流调至标准样片允许范围,先正向测量获取数据,再施加反向电流复测,取两次平均值作为单次测量结果;将样片转动 20°~30° 重复上述步骤,最终获得 10 个单次测量数据,取其均值作为最终测量值,通过Δρ=∣ρX−ρN∣计算示值误差(ρX为测试仪示值,ρN为标准样片实际值)。
三、标准不确定度评定

四探针电阻率测试仪测量结果的不确定度分量
四探针电阻率测试仪测量结果的不确定度由ρX和ρN的不确定度决定,分别采用 A 类、B 类方法评定。
u(ρX)的 A 类评定:该分量由仪器测量重复性引入,对标准样片的 10 次重复测量平均值为 0.9348 Ω・cm,通过贝塞尔公式计算得单次实验标准偏差 0.0029 Ω・cm,最终u(ρX)=ns(ρi)=0.0009 Ω·cm(n=10为测量次数)。
u(ρN)的 B 类评定:该分量由温度影响和上级证书传递的不确定度组成。标准样片 23℃下实际值为 0.938 Ω・cm,温度系数 0.00707 Ω・cm/(Ω・cm・℃),按 1℃温度偏差计算得温度引入分量u1(ρN)=0.007 Ω・cm;标准样片校准证书给出扩展不确定度 1.5%,取包含因子k=2,计算得证书传递分量u2(ρN)=0.007 Ω·cm。
四、合成与扩展不确定度评定
各不确定度分量相互独立,且灵敏系数均为 1,合成标准不确定度通过方和根法计算:uc(Δρ)=u2(ρx)+u12(ρN)+u22(ρN)=0.01 Ω·cm。
取包含因子k=2(对应 95% 置信概率),计算得扩展不确定度U=kuc(Δρ)=0.02 Ω・cm,相对扩展不确定度Urel=2%。
综上,试验评定确定四探针电阻率测试仪电阻率测量结果的相对扩展不确定度为 2%(k=2)。实验表明,10 次重复测量有效降低了测量重复性带来的误差,而温度影响是不确定度的主要来源。因此,在四探针电阻率测试仪的检定与实际使用中,需严格控制环境温度稳定性,减少温度偏差对测量结果的干扰,进一步提升电阻率测量的准确度和数据可靠性。
Xfilm埃利四探针方阻仪

Xfilm埃利四探针方阻仪用于测量薄层电阻(方阻)或电阻率,可以对最大230mm 样品进行快速、自动的扫描, 获得样品不同位置的方阻/电阻率分布信息。
超高测量范围,测量1mΩ~100MΩ
高精密测量,动态重复性可达0.2%
全自动多点扫描,多种预设方案亦可自定义调节
快速材料表征,可自动执行校正因子计算
基于四探针法的Xfilm埃利四探针方阻仪,凭借智能化与高精度的电阻测量优势,可助力评估电阻,推动多领域的材料检测技术升级。