基于微四探针测量的热电性能表征
随着电子器件尺寸持续缩小,热管理问题日益突出。热电材料的三项关键参数——电导率(σ)、热导率(κ)和塞贝克系数(α),共同决定了器件的热电优值(ZT),进而影响其能效与可靠性。四探针技术因其高空间分辨率、无损接触和快速测量等优势常应用于电导率测量,Xfilm 埃利四探针方阻仪是电导率测量的重要设备。本文将解析基于谐波电压分析的微四探针方法,旨在通过单一测量同时获取σ与α/κ,为全面评估材料热电性能提供了新手段。
一、数值模拟与理论验证
本研究首先通过多物理场仿真软件COMSOL Multiphysics构建了热电耦合数值模型,对测量理论进行了验证。模拟结果与解析预测高度一致,在电压幅值与相位上的平均误差小于1%,为实验方法的可靠性奠定了坚实基础。
二、样品制备与表征
实验样品包括5组校准样品(均匀掺杂的p型与n型硅片)和5组测试样品(Ge、Si:As及多晶BiTe块体)。校准样品的κref和αref分别通过瞬态平面源法(TPS)和斜率法测得,其标准误差控制在2.5%以内,为微四探针测量结果提供了可靠的基准。
三、微四探针测量流程
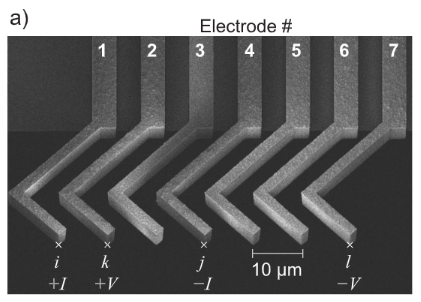
本研究中使用的七电极探针的扫描电子显微镜图像
测量使用四探针设备,配备七电极探针,电极间距为10 μm。采用频率为12.06 Hz的交流电流,在0.5–5 mA范围内调节电流强度,并利用锁相放大器精确记录各谐波下的电压与相位。通过多达158种四探针构型的组合测量,系统性地提取基波电阻(R₁ω)与二次谐波电压(V₂ω),并采用三步拟合流程依次得到电阻率、接触半径及最终的α/κ比值。
四、理论模型的实验验证

样品 4790 在4.08 mA 电流下测得的微四探针数据
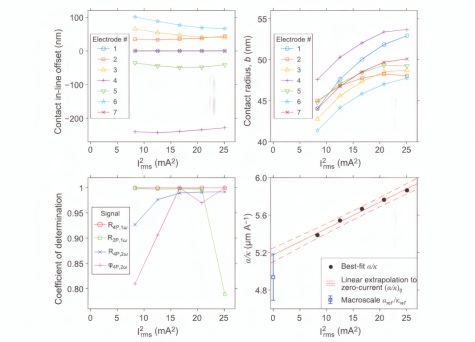
样品 4790 的拟合结果汇总,以电流平方为横坐标绘制
以样品4790(p型Si:B)为例,在4.08 mA电流下,其基波与二次谐波测量数据与模型拟合优度(R²)均超过0.95,证明了理论模型的准确性。通过将不同电流下的α/κ比值外推至零电流,有效消除了电阻温度系数的影响,获得α/κ比值为5.18 ± 0.03 μm A⁻¹,与宏观参考值4.93 ± 0.25 μm A⁻¹高度吻合。
五、塞贝克系数的微区测量结果
在所有5组校准样品中,微四探针测得的塞贝克系数(αM4PP)与参考值(αref)的误差均在不确定度范围内。对于测试样品,除Ge:Sb因费米能级钉扎效应无法有效测量外,其余如Si:As(αM4PP = -432 μV K⁻¹ vs αref = -435 μV K⁻¹)与Ge:Ga(αM4PP = 560 μV K⁻¹ vs αref = 540 μV K⁻¹)均表现良好。BiTe样品因多晶各向异性及电流路径复杂性,测量值偏离文献参考约20–30%,这反映了微区测量对局部微观结构的敏感性。
本实验成功开发并验证了一种基于微四探针的谐波电压分析方法,能够在微米尺度下同时测量材料的电导率与塞贝克系数/热导率比值。该方法在多种半导体材料中表现出高精度与重复性,为微纳器件热电性能的原位表征提供了有力工具。
Xfilm埃利四探针方阻仪
Xfilm埃利四探针方阻仪用于测量薄层电阻(方阻)或电导,可以对样品进行快速、自动的扫描,获得样品不同位置的方阻/电阻率分布信息。

超高测量范围,测量1mΩ~100MΩ
高精密测量,动态重复性可达0.2%
全自动多点扫描,多种预设方案亦可自定义调节
快速材料表征,可自动执行校正因子计算
基于四探针法的Xfilm埃利四探针方阻仪,凭借智能化与高精度的电阻测量优势,助力评估电子器件材料的热电性能,推动多领域的材料检测技术升级。